光刻膠顯影和光刻工藝
摘要
簡要介紹關(guān)于光刻膠的顯影過程和光刻工藝處理的一些相關(guān)內(nèi)容。
引言
光刻工藝可用五個(gè)指標(biāo)來衡量其效果:分辨率、靈敏度、套刻對準(zhǔn)精度、缺陷率和硅片加工過程處理問題,其中有 3 個(gè)指標(biāo),分辨率、靈敏度和缺陷率是與涂膠顯影的工藝精度有重要聯(lián)系。
正文
顯影過程是將曝光后的光刻膠中與紫外光發(fā)生化學(xué)反應(yīng)的部分除去或保留下來的過程。顯影的主要過程如下:
對準(zhǔn)曝光→曝光后烘→顯影→堅(jiān)膜→顯影檢測。
1、 對準(zhǔn)曝光(Alignment and Exposure)
對準(zhǔn)曝光階段是光刻工藝的重要階段,使用的掩膜曝光機(jī),即光刻機(jī),集中了光刻工藝中最重要的工藝技術(shù)。
對準(zhǔn)曝光過程通常在黃光實(shí)驗(yàn)室(圖 1)中進(jìn)行。
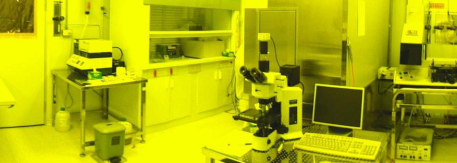
圖 1 黃光實(shí)驗(yàn)室
使用的光刻機(jī)(圖 2)也根據(jù)不同的曝光原理,分為接觸式曝光,接近式曝光和投影式曝光。也可按自動(dòng)化程度高低分成手動(dòng)式,半自動(dòng)式,和全自動(dòng)式光刻機(jī)。
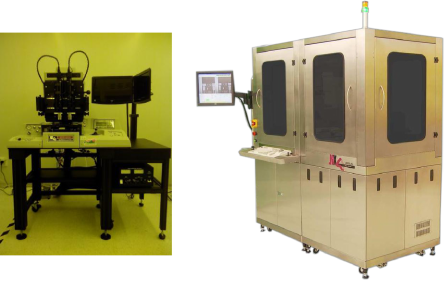
圖 2 光刻機(jī)
2、 曝光后烘(PEB)
曝光后應(yīng)盡快進(jìn)行顯影步驟中的烘干處理,從而有效降低駐波效應(yīng)的影響,這是由于曝光過程中,入射光和反射光會(huì)產(chǎn)生相互干涉,其光強(qiáng)會(huì)沿著膠體水平方向形成波紋形狀,即駐波。
目前通常采用曝光后立刻烘干方式,即 PEB,減少駐波效應(yīng)帶來的影響。
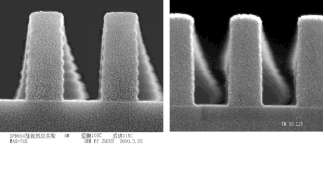
左圖:無 PEB 右圖:PEB 之后
3、顯影(develop)
PEB 之后,硅片冷卻至 23℃左右,與顯影液溫度相同,并與顯影液發(fā)生化學(xué)反應(yīng)。
一般來說,顯影過程中被曝光和未曝光部分的光刻膠都會(huì)與光刻膠發(fā)生反應(yīng),因此,為得到良好的顯影效果,可以通過改變顯影液成分,顯影溫度,顯影方式,與顯影步驟等因素來加快曝光與為曝光部分光刻膠的溶解速率。
若對顯影的要求不高,可以直接將硅片放入顯影液槽中浸泡然后取出。對于大部分對顯影要求較高的生產(chǎn)及實(shí)驗(yàn)過程,通常使用專用的勻膠顯影機(jī)來自動(dòng)控制顯影過程,如圖 3 所示。

圖 3 勻膠顯影機(jī)
目前,顯影主要有三種方法,即連續(xù)噴霧顯影(SPRAY)、旋轉(zhuǎn)浸潤顯影(IMMESESEION)和靜態(tài)顯影(PUDDLE)。
4、堅(jiān)膜(HB Hardbake)
堅(jiān)膜也稱為硬烘,是對顯影后的光刻膠加熱烘干,促使光刻膠與硅片粘著牢固,并且沒有發(fā)生形變。堅(jiān)膜階段的溫度一般控制在 100-120℃之間,若加熱溫度過高會(huì)使得光刻膠軟化,如圖 4 所示,并導(dǎo)致后期去膠困難。
一般使用熱板或烘箱來控制溫度變化。

圖 4 后烘加熱過高,光刻膠軟化
5、顯影檢測(ADI,After Development Inspection)
ADI是檢查硅片表面的缺陷。通常將一個(gè)無缺陷的標(biāo)準(zhǔn)圖形存于電腦中,然后用每個(gè)芯片的圖形與標(biāo)準(zhǔn)相比較,觀察出現(xiàn)多少不同的點(diǎn),就會(huì)在硅片的defect map 中顯示多少個(gè)缺陷。
在顯影溶解過程中,如果不能很好的控制顯影過程,光刻膠圖形就會(huì)出現(xiàn)顯影不足,不完全顯影,過顯影等問題,如圖5所示。
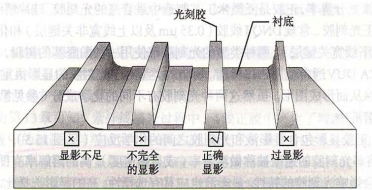
圖 5 光刻膠顯影問題
標(biāo)簽: 光刻 顯影 光刻機(jī) 光刻膠 顯影液
- 上一條組成ELISA試劑盒的是什么?
- 下一條真空干燥箱使用安全警告

